SMT hutumia uchanganuzi wa kawaida wa tundu la utiririshaji hewa wa solder na suluhisho (Toleo la Essence la 2023), unastahili!
1 Utangulizi

Katika mkusanyiko wa bodi ya mzunguko, kuweka solder huchapishwa kwenye pedi ya bodi ya mzunguko kwanza, na kisha vipengele mbalimbali vya elektroniki vinawekwa. Hatimaye, baada ya tanuru ya reflow, shanga za bati katika kuweka solder huyeyuka na kila aina ya vipengele vya elektroniki na pedi ya solder ya bodi ya mzunguko huunganishwa pamoja ili kutambua mkusanyiko wa submodules za umeme. surfacemounttechnology (sMT) inazidi kutumika katika vifungashio vyenye msongamano wa juu, kama vile kifurushi cha kiwango cha mfumo (siP), vifaa vya ballgridarray (BGA), na Chip isiyo na nguvu, kifurushi cha mraba gorofa kisicho na pini (quad aatNo-lead, kinachojulikana kama QFN) kifaa.
Kutokana na sifa za mchakato wa kulehemu kuweka solder na vifaa, baada ya kulehemu reflow ya vifaa hivi kubwa ya uso solder, kutakuwa na mashimo katika eneo la kulehemu solder, ambayo yataathiri mali ya umeme, mali ya mafuta na mali ya mitambo ya Utendaji wa bidhaa, na hata kusababisha kushindwa kwa bidhaa, kwa hiyo, ili kuboresha solder kuweka reflow kulehemu cavity imekuwa mchakato na tatizo la kiufundi ambayo baadhi ya sababu za utafiti lazima kutatuliwa na kutatuliwa kwa ajili ya utafiti BGA. kulehemu cavity, na zinazotolewa uboreshaji ufumbuzi, kawaida solder kuweka reflow kulehemu mchakato kulehemu eneo la QFN kubwa kuliko 10mm2 au kulehemu eneo kubwa kuliko 6 mm2 ya ufumbuzi Chip wazi ni kukosa.
Tumia kulehemu kwa Preformsolder na kulehemu kwa tanuru ya utupu ya reflux ili kuboresha shimo la weld. Solder iliyotengenezwa tayari inahitaji vifaa maalum ili kuelekeza flux. Kwa mfano, chip hurekebishwa na kuelekezwa kwa umakini baada ya chip kuwekwa moja kwa moja kwenye solder iliyotengenezwa tayari. Ikiwa chip ya mlima wa flux inatiririka tena na kisha kuelekeza, mchakato huongezwa kwa utiririshaji mara mbili, na gharama ya solder iliyotengenezwa tayari na nyenzo za flux ni kubwa zaidi kuliko kuweka solder.
Vifaa vya reflux ya utupu ni ghali zaidi, uwezo wa utupu wa chumba cha utupu wa kujitegemea ni mdogo sana, utendaji wa gharama sio juu, na tatizo la umwagaji wa bati ni kubwa, ambayo ni jambo muhimu katika matumizi ya bidhaa za juu-wiani na za lami ndogo. Katika karatasi hii, kwa kuzingatia mchakato wa kulehemu wa kawaida wa solder kuweka reflow, mchakato mpya wa kulehemu wa reflow wa sekondari hutengenezwa na kuletwa ili kuboresha cavity ya kulehemu na kutatua matatizo ya kuunganisha na kupasuka kwa muhuri wa plastiki unaosababishwa na cavity ya kulehemu.
2 Solder kuweka uchapishaji reflow kulehemu cavity na utaratibu wa uzalishaji
2.1 Cavity ya kulehemu
Baada ya kulehemu tena, bidhaa ilijaribiwa chini ya x-ray. Mashimo katika eneo la kulehemu na rangi nyepesi yalipatikana kwa sababu ya kutokuwepo kwa solder kwenye safu ya kulehemu, kama inavyoonyeshwa kwenye Mchoro 1.
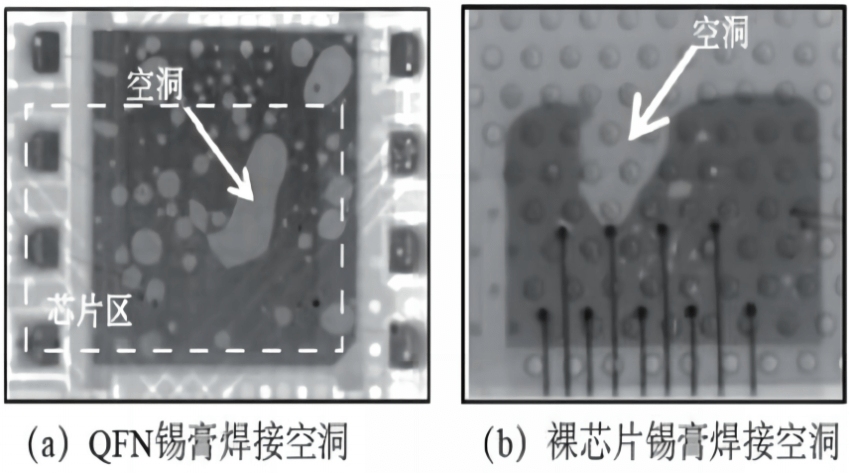
Utambuzi wa X-ray wa shimo la Bubble
2.2 Utaratibu wa malezi ya cavity ya kulehemu
Kwa kuchukua sAC305 solder kuweka kama mfano, muundo kuu na kazi ni inavyoonekana katika Jedwali 1. Flux na bati shanga ni kushikamana pamoja katika umbo la kuweka. Uwiano wa uzito wa solder ya bati kwa flux ni kuhusu 9: 1, na uwiano wa kiasi ni kuhusu 1: 1.

Baada ya kuweka solder kuchapishwa na kuunganishwa na vipengele mbalimbali vya elektroniki, kuweka solder itapitia hatua nne za preheating, uanzishaji, reflux na baridi wakati inapita kupitia tanuru ya reflux. Hali ya kuweka solder pia ni tofauti na halijoto tofauti katika hatua tofauti, kama inavyoonyeshwa kwenye Mchoro 2.
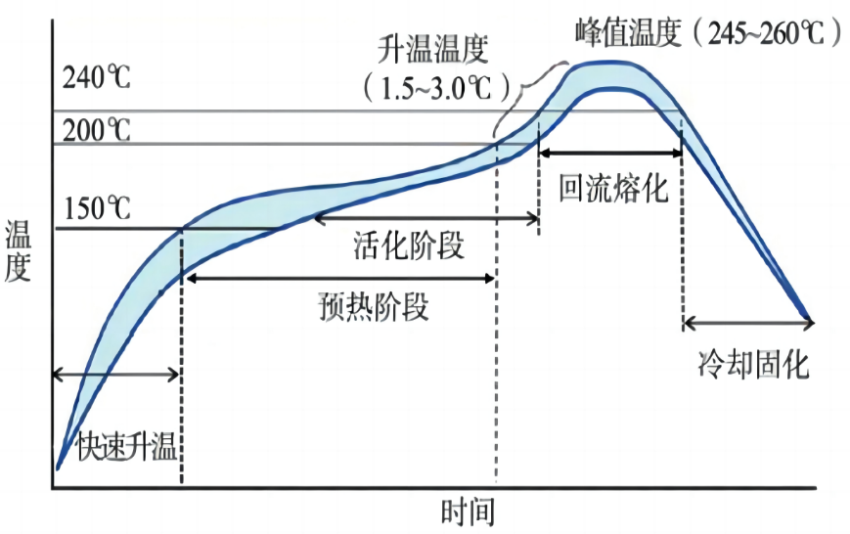
Rejeleo la wasifu kwa kila eneo la kutengenezea tena mtiririko
Katika hatua ya preheating na uanzishaji, vipengele tete katika flux katika kuweka solder itakuwa volatilized katika gesi wakati joto. Wakati huo huo, gesi zitatolewa wakati oksidi kwenye uso wa safu ya kulehemu imeondolewa. Baadhi ya gesi hizi zitabadilika na kuacha kuweka solder, na shanga za solder zitaunganishwa kwa nguvu kutokana na tete ya flux. Katika hatua ya reflux, flux iliyobaki katika kuweka solder itayeyuka haraka, shanga za bati zitayeyuka, kiasi kidogo cha gesi tete ya flux na hewa nyingi kati ya shanga za bati haitatawanywa kwa wakati, na mabaki katika bati ya kuyeyuka na chini ya mvutano wa bati iliyoyeyuka hukamatwa na sandwichi ya muundo na sehemu ya elektroniki ya sandwich. amefungwa katika bati kioevu ni vigumu kutoroka tu na buoyancy juu Wakati wa juu wa kuyeyuka ni mfupi sana. Wakati bati la kuyeyushwa linapoa na kuwa bati gumu, vinyweleo huonekana kwenye safu ya kulehemu na mashimo ya kutengenezea hutengenezwa, kama inavyoonyeshwa kwenye Mchoro 3.
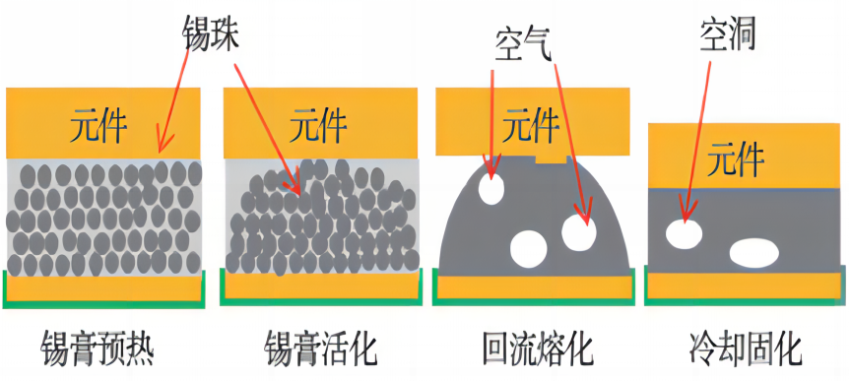
Mchoro wa mpangilio wa utupu unaotokana na kulehemu tena kwa utiririshaji wa bandika ya solder
Sababu ya mizizi ya cavity ya kulehemu ni kwamba hewa au gesi tete iliyofunikwa kwenye kuweka solder baada ya kuyeyuka haijatolewa kabisa. Sababu zinazoathiri ni pamoja na nyenzo za kuweka solder, sura ya uchapishaji ya kuweka solder, kiasi cha uchapishaji cha kuweka, joto la reflux, wakati wa reflux, ukubwa wa kulehemu, muundo na kadhalika.
3. Uthibitishaji wa mambo ya ushawishi wa solder kuweka uchapishaji reflow kulehemu mashimo
Vipimo vya QFN na chip tupu vilitumiwa kudhibitisha sababu kuu za utupu wa kulehemu, na kutafuta njia za kuboresha voids za kulehemu zilizochapishwa na kuweka solder. QFN na tupu chip solder kuweka reflow kulehemu profile profile inavyoonekana katika Mchoro 4, QFN kulehemu uso ukubwa ni 4.4mmx4.1mm, kulehemu uso ni bati safu (100% safi bati); Ukubwa wa kulehemu wa chip tupu ni 3.0mmx2.3mm, safu ya kulehemu ni sputtered nickel-vanadium bimetallic safu, na safu ya uso ni vanadium. Pedi ya kulehemu ya substrate ilikuwa electroless nickel-palladium dhahabu-dipping, na unene ilikuwa 0.4μm/0.06μm/0.04μm. SAC305 solder paste hutumiwa, vifaa vya uchapishaji vya solder paste ni DEK Horizon APix, vifaa vya tanuru ya reflux ni BTUPyramax150N, na vifaa vya x-ray ni DAGExD7500VR.
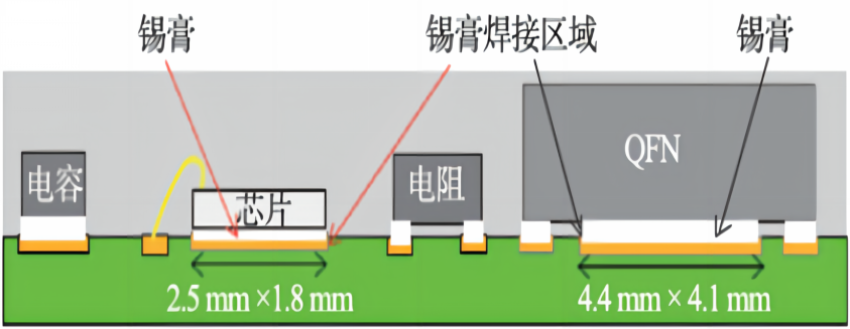
QFN na michoro ya kulehemu ya chip tupu
Ili kuwezesha ulinganisho wa matokeo ya mtihani, kulehemu kwa mtiririko upya kulifanyika chini ya masharti katika Jedwali 2.

Jedwali la hali ya kulehemu tena
Baada ya kuweka uso na kulehemu tena kukamilika, safu ya kulehemu iligunduliwa na X-ray, na iligunduliwa kuwa kulikuwa na mashimo makubwa kwenye safu ya kulehemu chini ya QFN na chip isiyo wazi, kama inavyoonyeshwa kwenye Mchoro 5.
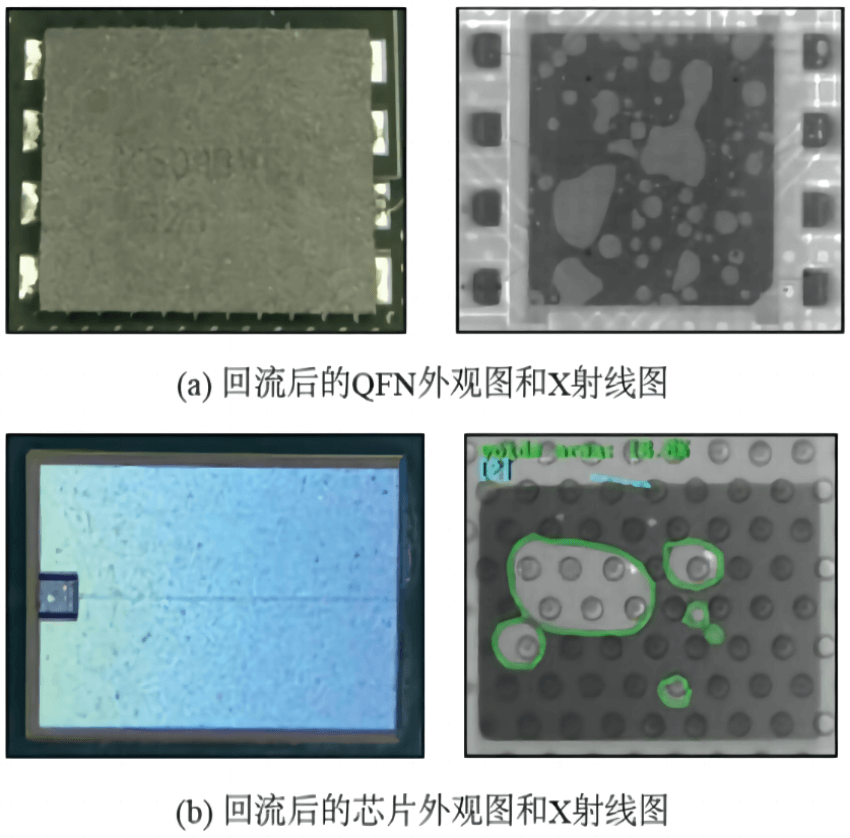
Hologram ya QFN na Chip (X-ray)
Kwa kuwa saizi ya ushanga wa bati, unene wa matundu ya chuma, kiwango cha eneo la ufunguzi, umbo la matundu ya chuma, muda wa reflux na halijoto ya juu ya tanuru yote yataathiri utupu wa kulehemu, kuna mambo mengi yanayoathiri, ambayo yatathibitishwa moja kwa moja na jaribio la DOE, na idadi ya vikundi vya majaribio itakuwa kubwa sana. Inahitajika kukagua haraka na kuamua sababu kuu za ushawishi kupitia jaribio la ulinganisho wa ulinganifu, na kisha kuboresha zaidi sababu kuu za ushawishi kupitia DOE.
3.1 Vipimo vya mashimo ya solder na shanga za bati za kuweka
Na aina ya 3 (ukubwa wa shanga 25-45 μm) SAC305 mtihani wa kuweka solder, hali nyingine bado bila kubadilika. Baada ya kutiririka tena, mashimo kwenye safu ya solder hupimwa na kulinganishwa na kuweka solder type4. Imegundulika kuwa mashimo kwenye safu ya solder hayana tofauti kubwa kati ya aina mbili za kuweka solder, ikionyesha kwamba kuweka solder yenye ukubwa tofauti wa shanga haina ushawishi wa wazi kwenye mashimo kwenye safu ya solder, ambayo sio sababu ya ushawishi, kama inavyoonyeshwa kwenye FIG. 6 Kama inavyoonyeshwa.

Ulinganisho wa mashimo ya poda ya bati ya metali yenye ukubwa tofauti wa chembe
3.2 Unene wa cavity ya kulehemu na mesh ya chuma iliyochapishwa
Baada ya reflow, eneo la cavity ya safu ya svetsade ilipimwa na mesh ya chuma iliyochapishwa na unene wa 50 μm, 100 μm na 125 μm, na hali nyingine hazibadilika. Ilibainika kuwa athari za unene tofauti wa mesh ya chuma (solder paste) kwenye QFN ililinganishwa na ile ya mesh ya chuma iliyochapishwa na unene wa 75 μm Wakati unene wa mesh ya chuma huongezeka, eneo la cavity hupungua polepole. Baada ya kufikia unene fulani (100μm), eneo la tundu litabadilika na kuanza kuongezeka na ongezeko la unene wa matundu ya chuma, kama inavyoonyeshwa kwenye Mchoro 7.
Hii inaonyesha kwamba wakati kiasi cha kuweka solder kinaongezeka, bati ya kioevu yenye reflux inafunikwa na chip, na njia ya kutoroka ya mabaki ya hewa ni nyembamba tu kwa pande nne. Wakati kiasi cha kuweka solder kinapobadilishwa, sehemu ya kutoa hewa iliyobaki pia huongezeka, na mlipuko wa papo hapo wa hewa iliyofunikwa kwenye bati la kioevu au gesi tete inayotoka kwenye bati la kioevu itasababisha bati kioevu kumwagika karibu na QFN na chip.
Jaribio liligundua kuwa kwa kuongezeka kwa unene wa mesh ya chuma, kupasuka kwa Bubble kunasababishwa na kutoroka kwa hewa au gesi tete pia kutaongezeka, na uwezekano wa bati kunyunyiza karibu na QFN na chip pia utaongezeka sawasawa.

Ulinganisho wa mashimo katika mesh ya chuma ya unene tofauti
3.3 Uwiano wa eneo la cavity ya kulehemu na ufunguzi wa mesh ya chuma
Mesh ya chuma iliyochapishwa na kiwango cha ufunguzi cha 100%, 90% na 80% ilijaribiwa, na hali nyingine hazibadilika. Baada ya kukimbia tena, eneo la cavity la safu iliyo svetsade lilipimwa na ikilinganishwa na mesh ya chuma iliyochapishwa na kiwango cha kufungua 100%. Ilibainika kuwa hapakuwa na tofauti kubwa katika uso wa safu ya svetsade chini ya hali ya kiwango cha ufunguzi cha 100% na 90% 80%, kama inavyoonyeshwa kwenye Mchoro 8.

Ulinganisho wa cavity ya eneo tofauti la ufunguzi wa mesh tofauti ya chuma
3.4 Cavity iliyo svetsade na umbo la matundu ya chuma iliyochapishwa
Kwa mtihani wa sura ya uchapishaji wa kuweka solder ya strip b na gridi ya kutega c, hali nyingine bado hazijabadilika. Baada ya reflow, eneo la cavity ya safu ya kulehemu hupimwa na ikilinganishwa na sura ya uchapishaji ya gridi ya taifa a. Imegunduliwa kuwa hakuna tofauti kubwa katika safu ya safu ya kulehemu chini ya masharti ya gridi ya taifa, strip na gridi ya mwelekeo, kama inavyoonyeshwa kwenye Mchoro 9.
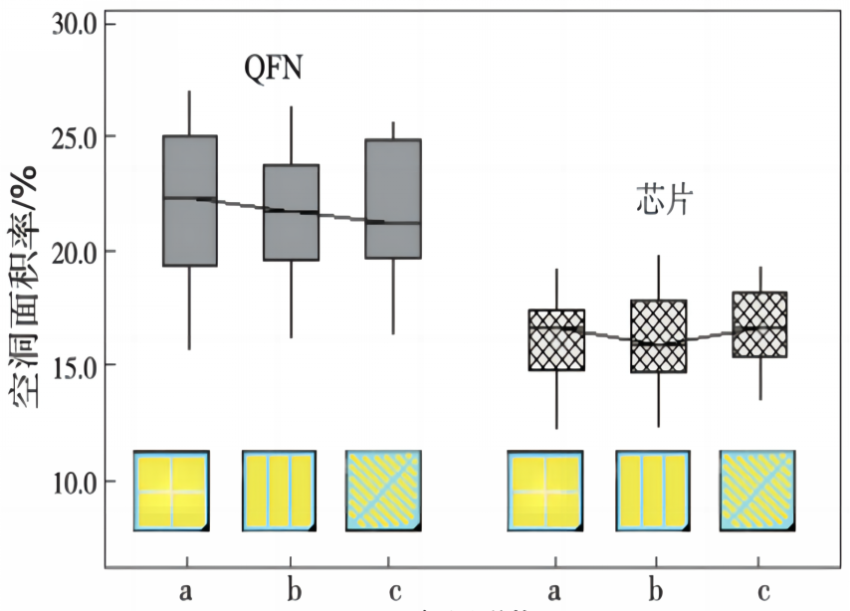
Ulinganisho wa mashimo katika njia tofauti za ufunguzi wa mesh ya chuma
3.5 Cavity ya kulehemu na wakati wa reflux
Baada ya muda wa reflux wa muda mrefu (70 s, 80 s, 90 s) mtihani, hali nyingine bado hazibadilika, shimo kwenye safu ya kulehemu ilipimwa baada ya reflux, na ikilinganishwa na muda wa reflux wa 60 s, iligundua kuwa kwa kuongezeka kwa muda wa reflux, eneo la shimo la kulehemu lilipungua, lakini kupunguzwa kwa kupunguzwa kwa muda wa kuongezeka kwa takwimu 1 kunaonyesha hatua kwa hatua. katika kesi ya muda wa kutosha wa reflux, kuongeza muda wa reflux ni mzuri kwa kufurika kamili ya hewa iliyofunikwa kwenye bati ya kioevu iliyoyeyuka, lakini baada ya kuongezeka kwa muda wa reflux hadi wakati fulani, hewa iliyofunikwa kwenye bati ya kioevu ni vigumu kufurika tena. Wakati wa Reflux ni moja ya sababu zinazoathiri cavity ya kulehemu.

Ulinganisho tupu wa urefu tofauti wa wakati wa reflux
3.6 Cavity ya kulehemu na joto la kilele la tanuru
Kwa kipimo cha joto cha 240 ℃ na 250 ℃ kilele cha joto la tanuru na hali zingine ambazo hazijabadilika, eneo la patiti la safu iliyochomwa lilipimwa baada ya kutiririka tena, na ikilinganishwa na joto la kilele la tanuru la 260 ℃, iligundulika kuwa chini ya hali tofauti za hali ya joto ya tanuru ya kilele, cavity ya safu ya svetsade ya QFN inaonyesha tofauti na chip 1. kilele cha joto la tanuru haina athari dhahiri kwenye QFN na shimo kwenye safu ya kulehemu ya chip, ambayo sio sababu ya kushawishi.

Ulinganisho tupu wa viwango vya joto tofauti vya kilele
Vipimo vilivyo hapo juu vinaonyesha kuwa mambo muhimu yanayoathiri safu ya weld ya QFN na chip ni wakati wa reflux na unene wa mesh ya chuma.
4 Solder kuweka uchapishaji reflow kulehemu uboreshaji cavity
Mtihani wa 4.1DOE ili kuboresha cavity ya kulehemu
Shimo katika safu ya kulehemu ya QFN na chip iliboreshwa kwa kupata thamani bora ya mambo kuu ya ushawishi (wakati wa reflux na unene wa mesh ya chuma). Uwekaji wa solder ulikuwa SAC305 type4, umbo la matundu ya chuma lilikuwa aina ya gridi ya taifa (shahada ya ufunguzi 100%), joto la juu la tanuru lilikuwa 260 ℃, na hali zingine za mtihani zilikuwa sawa na za vifaa vya majaribio. Mtihani wa DOE na matokeo yalionyeshwa katika Jedwali 3. Ushawishi wa unene wa mesh ya chuma na muda wa reflux kwenye QFN na mashimo ya kulehemu ya chip yanaonyeshwa kwenye Mchoro 12. Kupitia uchambuzi wa mwingiliano wa mambo makuu ya ushawishi, Imegunduliwa kuwa kutumia 100 μm unene wa mesh ya chuma na muda wa 80 s reflux inaweza kupunguza kwa kiasi kikubwa cavity ya kulehemu na chip ya QF. Kiwango cha cavity ya kulehemu ya QFN imepunguzwa kutoka kiwango cha juu cha 27.8% hadi 16.1%, na kiwango cha cavity ya kulehemu ya chip imepunguzwa kutoka kiwango cha juu cha 20.5% hadi 14.5%.
Katika jaribio, bidhaa 1000 zilitolewa chini ya hali bora (100 μm unene wa matundu ya chuma, wakati wa reflux wa 80), na kiwango cha cavity ya 100 QFN na chip kilipimwa kwa nasibu. Kiwango cha wastani cha cavity ya QFN kilikuwa 16.4%, na wastani wa kiwango cha cavity ya chip kilikuwa 14.7% Kiwango cha cavity ya weld ya chip na chip ni dhahiri kupunguzwa.

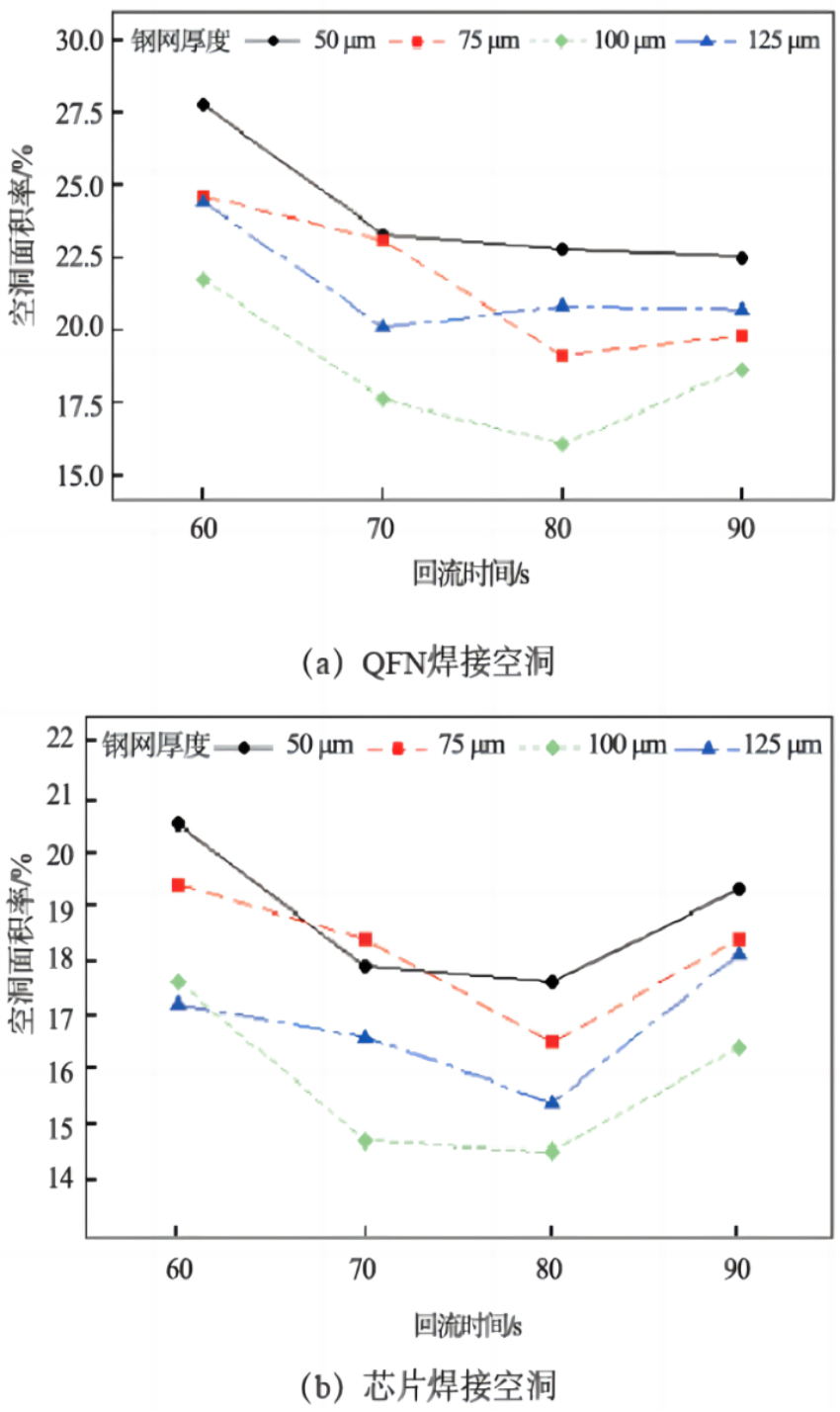
4.2 Mchakato mpya unaboresha cavity ya kulehemu
Hali halisi ya uzalishaji na mtihani unaonyesha kwamba wakati eneo la cavity ya kulehemu chini ya chip ni chini ya 10%, tatizo la kupasuka kwa nafasi ya chip halitatokea wakati wa kuunganisha na ukingo wa risasi. Vigezo vya mchakato vilivyoboreshwa na DOE haviwezi kukidhi mahitaji ya kuchambua na kutatua mashimo katika kulehemu ya kawaida ya solder kuweka reflow, na kiwango cha eneo la kulehemu la chip kinahitaji kupunguzwa zaidi.
Kwa kuwa chip iliyofunikwa kwenye solder inazuia gesi katika solder kutoka, kiwango cha shimo chini ya chip kinapunguzwa zaidi kwa kuondoa au kupunguza gesi iliyofunikwa ya solder. Mchakato mpya wa kulehemu reflow na uchapishaji mbili wa kuweka solder ni kupitishwa: moja solder kuweka uchapishaji, reflow moja si kufunika QFN na Chip wazi kutoa gesi katika solder; Mchakato maalum wa uchapishaji wa pili wa kuweka solder, kiraka na reflux ya pili imeonyeshwa kwenye Mchoro 13.
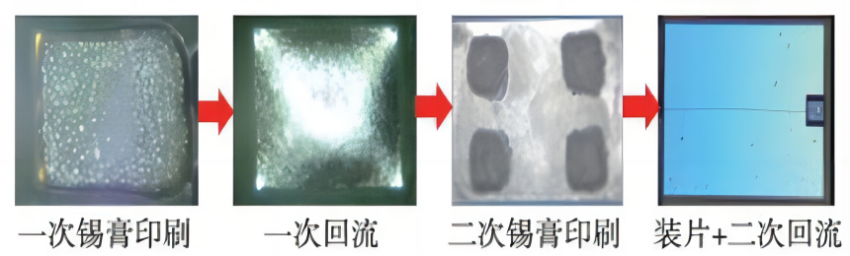
Wakati kuweka solder nene 75μm kuchapishwa kwa mara ya kwanza, gesi nyingi katika solder bila kifuniko cha chip hutoka kwenye uso, na unene baada ya reflux ni kuhusu 50μm. Baada ya kukamilika kwa reflux ya msingi, mraba mdogo huchapishwa kwenye uso wa solder kilichopozwa kilichoimarishwa (ili kupunguza kiasi cha kuweka solder, kupunguza kiasi cha kumwagika kwa gesi, kupunguza au kuondokana na spatter ya solder), na kuweka solder na unene wa 50 μm (matokeo ya juu ya mtihani yanaonyesha kuwa 100 μm ni unene wa 100 μm ni bora zaidi ya 10 μm, unene wa 10 μm . μm=50 μm), kisha usakinishe chip, na kisha urudi kupitia 80 s. Karibu hakuna shimo kwenye solder baada ya uchapishaji wa kwanza na utiririshaji tena, na kuweka solder katika uchapishaji wa pili ni ndogo, na shimo la kulehemu ni ndogo, kama inavyoonyeshwa kwenye Mchoro 14.
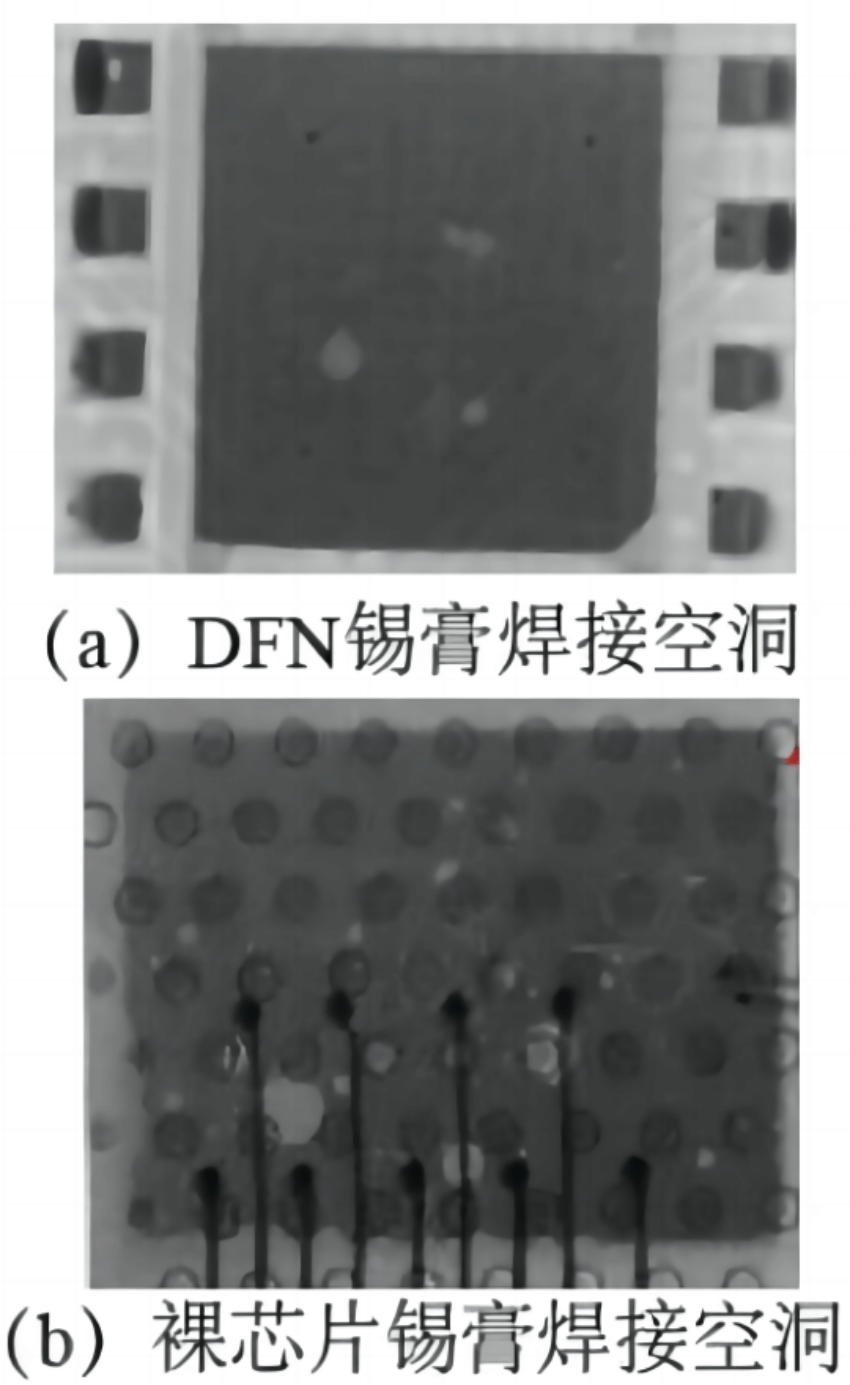
Baada ya uchapishaji mbili za kuweka solder, kuchora mashimo
4.3 Uthibitishaji wa athari ya cavity ya kulehemu
Uzalishaji wa bidhaa 2000 (unene wa mesh ya kwanza ya uchapishaji wa chuma ni 75 μm, unene wa mesh ya pili ya uchapishaji wa chuma ni 50 μm), hali nyingine hazijabadilika, kipimo cha random cha 500 QFN na kiwango cha cavity ya kulehemu ya chip, iligundua kuwa mchakato mpya baada ya reflux ya kwanza hakuna cavity, baada ya pili ya reflux ya kiwango cha juu cha kulehemu QFN na kiwango cha juu cha cavity ya QFN. Chip ni 4.1%. Ikilinganishwa na mchakato wa kulehemu wa uchapishaji wa kubandika moja na mchakato ulioboreshwa wa DOE, patiti ya kulehemu imepunguzwa sana, kama inavyoonyeshwa kwenye Mchoro 15. Hakuna nyufa za chip zilizopatikana baada ya majaribio ya kazi ya bidhaa zote.

5 Muhtasari
Uboreshaji wa kiasi cha uchapishaji wa kuweka solder na wakati wa reflux unaweza kupunguza eneo la cavity ya kulehemu, lakini kiwango cha cavity ya kulehemu bado ni kikubwa. Kutumia mbinu mbili za kulehemu za uchapishaji wa kuweka tena uchapishaji wa solder kunaweza kwa ufanisi na kuongeza kiwango cha cavity ya kulehemu. Eneo la kulehemu la chip tupu la mzunguko wa QFN linaweza kuwa 4.4mm x4.1mm na 3.0mm x2.3mm kwa mtiririko huo katika uzalishaji wa wingi Kiwango cha cavity ya kulehemu reflow inadhibitiwa chini ya 5%, ambayo inaboresha ubora na uaminifu wa kulehemu reflow. Utafiti katika karatasi hii unatoa kumbukumbu muhimu kwa ajili ya kuboresha tatizo la cavity ya kulehemu ya uso wa kulehemu wa eneo kubwa.






